| HOT! | 2023 | 恭賀!古沅翰、林佑欣同學 榮獲2023台積電博士獎學金 |
|---|---|---|
| HOT! | 2022 | 恭賀!張復翎同學 榮獲2022台積電博士獎學金 |
| HOT! | 2021 | 恭賀!高振宏 教授 榮獲科技部傑出特約研究員 (Merit MOST Research Fellow) |
| HOT! | 恭賀!高振宏 教授 榮獲ECTC Volunteer Award, IEEE Electronics Packaging Society | |
| HOT! | 恭賀! 施柏紹、黃薇禎同學 榮獲2021台積電博士獎學金 | |
| HOT! | 2020 | 恭賀!高振宏 教授榮獲 2020 Functional Materials Division Distinguished Scientist Award, TMS (美國 礦物、金屬、材料學會) |
| HOT! | 恭賀!高振宏 教授榮獲 Top 1% in Applied Physics according to standardized citation ranking by Ioannidis et al of Stanford University | |
| HOT! | 恭賀!洪漢堂同學 榮獲Best Student Paper Award, 2020 IMPACT-EMAP | |
| HOT! | 恭賀!黃正豪同學 榮獲2020台積電博士獎學金 | |
| HOT! | 2019 | 恭賀!高振宏 教授榮獲 Best Interactive Presentation Paper Award, 2019 IEEE Electronic Components and Technology Conference |
| HOT! | 恭賀!洪漢堂同學 榮獲 Best Interactive Presentation Paper Award, 2019 IEEE Electronic Components and Technology Conference | |
| HOT! | 恭賀!楊弘偉同學 榮獲 Intel Best Student Paper Award, 2019 IEEE Electronic Components and Technology Conference | |
| HOT! | 恭賀!楊弘偉同學 榮獲 2019 IEEE ECTC Student Travel Award | |
| HOT! | 恭賀!楊弘偉同學 榮獲 2019 台灣半導體產業協會 (TSIA) 博士研究生半導體獎 | |
| HOT! | 恭賀!李珮慈同學 榮獲 2019 National Synchrotron Radiation Research Center 25th Users’ Meeting & Workshops Poster Award | |
| HOT! | 恭賀!高振宏 教授榮任 IEEE Components, Packaging and Manufacturing Technology Society 理事 (Board of Governors), 任期2016-2018年與2019-2021年。該學會是 IEEE 旗下38個學會之一, 也是世界規模最大之電子零組件與封裝製造之相關學會。 | |
| 2017 | 恭賀!楊淳安同學 榮獲 2017 IEEE Electronic Components and Technology Conference Texas Instruments Outstanding Student Interactive Presentation Award | |
| 恭賀!高振宏 教授榮任國立台灣大學特聘教授 | ||
| 2016 | 恭賀!楊竣翔、楊弘偉同學 榮獲 2016 IEEE Japan Chapter Young Award | |
| 恭賀!楊竣翔同學 榮獲 2016 PCB學生優秀論文獎 | ||
| 恭賀!余人睿同學 榮獲 2016 IEEE ECTC Student Travel Award | ||
| 2015 | 恭賀!余人睿同學 榮獲 2015 Japan Insitute of Elecronics Packaging Poster Award | |
| 恭賀!李澄傑同學 榮獲 2015 TMS Best Paper Award | ||
| 恭賀!高振宏 教授榮任亞太材料科學院院士, Academician, Asia-Pacific Academic of Materials, 2015 | ||
| 2014 | 恭賀!楊挺立同學 榮獲 IMPACT-EMAP 2014年 "Student Paper Award" | |
| 恭賀!鍾丞凱同學 於第13屆世界電子電路大會 (ECWC13)中獲得優秀論文獎(Best Paper Award)殊榮 | ||
| 恭賀!楊挺立同學 獲得2014年台灣半導體產業協會第一屆博士研究生半導體獎 | ||
| 2013 | 恭賀!高振宏 教授榮任「國科會材料工程學門」召集人 | |
| 恭賀!高振宏 教授參加國科會工程技術發展處102年度技術及知識應用 型產學合作計畫榮獲"產學成果優良獎" | ||
| 恭賀!高振宏 教授之學生鍾丞凱同學榮獲"奇美實業優秀人才獎學金" | ||
| 恭賀!高振宏 教授榮獲美國TMS學會2014年"BRIMACOMBE MEDALIST AWARD" | ||
| 恭賀!楊挺立同學 獲美國IBM公司於 2013/10/30之IBM Intern Spotlight Program中報導 | ||
| 恭賀!高振宏 教授在 Journal of The Minerals, Metals & Materials Society, Vol. 65, No.9, SEPTEMBER, 2013 期刊中發表 評論 | ||
| 恭賀!鍾丞凱同學 榮獲2013 IMPACT論文金獎 | ||
| 恭賀!楊挺立同學 獲得2013年中國材料科學學學年會學生海報 論文獎佳作 | ||
| 恭賀!高振宏 教授獲邀擔任High Impact Research Icon, University of Malaya, Kuala Lumpur, 2013-2015. | ||
| 恭賀!高振宏 教授學術文章獲選為國際知名期刊Journal of Applied Physics之封面文章 | ||
| 2012 | 恭賀!高振宏 主任指導之博士生 楊挺立同學 於2012年先進功能材料全國博士生學術論壇暨海峽兩岸博士生論壇獲獎 | |
| 恭賀!實驗室多位同學在2012 MRS-T材料年會獲得獎項 優勝:陳郁仁、郭楣詩 [3D IC微尺度下微小銲點之金脆效應] 優勝:楊挺立 [Sn Grain Orientation Effect on the Formation of Highly Serrated Cathode Interface in Solder Joints under Electromigration] 佳作:李澄傑、余人睿、朱子軒 [Volume shrinkage induced by interfacial reaction in micro Ni/Sn/Ni structure] | ||
| 恭賀!楊挺立同學 獲得2012 PCB學院優秀論文獎 優等,於2012年10月24日TPCA Show 開幕式頒發獎項 | ||
| 恭賀!高振宏 教授榮任 International Materials Reviews (Impact Factor=6.962) Editional Board | ||
| 恭賀!高振宏 教授榮任美國金屬學會會士 | ||
| 依照ISI Essential Science Indicators 2012.5.1版統計,MICROELECTRON REL, 49 (3): 248-252 MAR 2009已被ISI列為 "HighlyCited Papers",亦即該文被引用次數排名其領域前1%。本團隊已第五次獲取此榮譽 | ||
| 2011 | 恭賀!高振宏 教授論文為TMS引用次數最高十篇之一 | |
| 恭賀!郭楣詩、莊鑫毅同學 榮獲2011 PCB學院優等獎 | ||
| 恭賀!余人睿同學 榮獲12th世界電子電路大會最佳論文獎 | ||
| 恭賀!楊挺立同學 榮獲AMD Technical Forum and Exhibition 2011最佳海報論文獎 | ||
| 恭賀!高振宏 教授 擔任The Minerals, Metals & Materials Society 的 William Hume-Rothery Award, Champion H. Mathewson Award,Institute of Metals Lecture/Robert Frankly Mehl Award, and Acta Materialia Gold Medal Award Subcommittee與John Bardeen Award Committee 委員會委員 |
Flip Chip Package / Lead Free Solder / 3D IC / Elecromigration
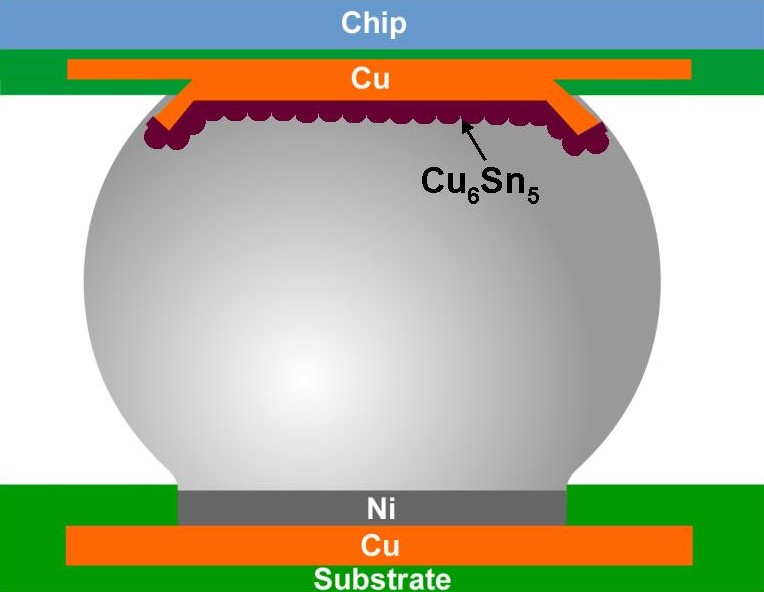
Department of Materials Science and Engineering, National Taiwan University
0 PUBLICATIONS
WI, USA
IL, USA
Taiwan, ROC
Department of Materials Science and Engineering
College of Engineering
Material science
Materials Science and Engineering
Department of Materials Science and Enginnering
Department of Materials Science and Engineering
Board of directors
Graduate Institute of Materials Science & Engineering
Department of Chemical & Materials Engineering
IEEE Transactions on Electronics Packaging Manufacturing
The Electronic, Magnetic & Photonic Materials Division
Department of Materials Science & Engineering
September Issue, 2001; November Issue, 2002; October Issue, 2003;
December Issue, 2003; October Issue, 2004; October Issue, 2005;
January Issue, 2006; December Issue, 2006.
JOM journal
Department of Chemical Engineering
Department of Chemical Engineering
Department of Materials Science & Engineering